Laboratorium Cienkich Warstw (ALD)
Laboratorium wykonuje prace badawcze i usługowe dotyczące kontrolowanego wytwarzania warstw tlenków metali w skali nanometrycznej z wykorzystaniem reaktora osadzania warstw atomowych (ALD).
PROCES ALD
Osadzanie warstw atomowych ALD (z ang. Atomic Layer Deposition) to metoda osadzania cienkich warstw (grubości pojedynczych nanometrów) oparta na sekwencyjnym zastosowaniu chemicznego osadzania z fazy gazowej. Większość reakcji ALD wykorzystuje dwie substancje chemiczne zwane prekursorami. Prekursory te reagują z powierzchnią materiału pojedynczo, w sekwencyjny, samoograniczający się sposób. Poprzez powtarzaną ekspozycję na kolejne prekursory powoli osadzana jest cienka powłoka. ALD jest kluczowym procesem w produkcji powłok półprzewodnikowych i stanowi istotne narzędzie do syntezy nanomateriałów.
Podczas osadzania cienkiej powłoki na podłożu wystawia się jego powierzchnię na działanie naprzemiennego działania różnych gazów (prekursorów). W przeciwieństwie do pozostałych metod chemicznego osadzania z fazy gazowej (CVD), prekursory nigdy nie są obecne jednocześnie w reaktorze, ale są wpompowywane do komory jako szereg następujących po sobie impulsów. W każdym z tych impulsów cząsteczki prekursora reagują z powierzchnią w sposób samoograniczający, tak że proces kończy się, gdy wszystkie wiązania na powierzchni zostaną zapełnione. W konsekwencji maksymalna ilość materiału osadzonego na powierzchni po jednorazowym wystawieniu na działanie wszystkich prekursorów (tak zwany cykl ALD) jest określona przez naturę interakcji prekursor – powierzchnia. Zwiększając liczbę cykli, możliwe jest równomierne osadzanie powłok na dowolnie złożonych i dużych podłożach.
WŁAŚCIWOŚCI PROCESU OSADZANIA I POWŁOK
- Doskonała adhezja: chemisorpcja prekursorów z powierzchnią zapewnia doskonałą adhezję.
- Wysycenie: samoistne reakcje powierzchniowe umożliwiają automatyczny proces bez konieczności ciągłej obecności operatora i precyzyjnego dozowania.
- Sekwencyjność: Wzrost sekwencyjny zapewnia niespotykaną dokładność.
- Reakcje sterowane powierzchniowo: reakcje powierzchniowe umożliwiają pokrycie powłokami materiałów o różnych kształtach i właściwościach podłoża.
- Precyzyjny i powtarzalny: wzrost grubości warstwy podczas jednego cyklu ALD jest specyficzny dla danego procesu, ale zwykle wynosi około 0,1 nm.
- Cienka, gęsta i gładka: ALD umożliwia osadzanie warstw poniżej jednego nanometra grubości. Powłoki cienkie jak 0,8 nm są obecnie stosowane w niektórych zastosowaniach przemysłowych.
- Wysoka wydajność: Funkcja sterowania wzrostem powierzchni pozwala na zwiększenie mocy produkcyjnych dla dużych partii i dużych powierzchni.
- ALD wspomagane plazmą: Powłoki ALD można modyfikować przy zastosowaniu plazmy w trakcie cyklu osadzania, na przykład, aby umożliwić powlekanie pewnymi metalami lub tlenkami i azotkami o niskiej temperaturze topnienia.
- ALD na cząstkach i proszkach: Połączenie powłok ochronnych z cząstkami jako podłożem stwarza zupełnie nowe możliwości, na przykład pozwala modyfikować właściwości dyfuzyjne.
ZASTOSOWANIE ALD
- mikroelektronika, bramki tlenowe, czujniki, panele słoneczne, ogniwa paliwowe,
- powłoki odporne na zużycie,
- materiały porowate – maski,
- warstwy ochronne (np.: srebro),
- wielowarstwowe (np.: warstwy elektroluminescencyjne),
- nanolaminaty (np.: Al2O3 + TiO2, dielektryki, lustra),
- powłoki bakteriobójcze,
- panele solarne,
- czujniki,
- energetyka – funkcjonalne powłoki cienkowarstwowe (ochrona przed korozją i zużyciem ściernym, ochrona przed gazami).
MATERIAŁAMI NAJCZĘŚCIEJ NANOSZONYMI METODĄ ALD SĄ
- Tlenki: Al2O3, CaO, CuO, Er2O3, Ga2O3, HfO2, La2O3, MgO, Nb2O5, Sc2O3, SiO2, Ta2O5, TiO2, VXOY, Y2O3, Yb2O3, ZnO, ZrO2, etc.
- Azotki: AlN, GaN, TaNx, TiAlN, TiNX, etc.
- Węgliki: TaC, TiC, etc.
- Metale: IR, Pd, Pt, Ru, etc.
- Siarczki: ZnS, SrS, etc.
- Fluorki: CaF2, LaF3, MgF2, SrF2, etc.
- Biomateriały: Ca10(PO4)6(OH)2 (hydroksyapatyt)
- Polimery: PMDA-DAH, PMDA-ODA, etc.
ALD jest technologią umożliwiającą produkcję nowych i ulepszonych produktów. Zapewnia właściwości powłok i materiału, których nie można uzyskać w opłacalny sposób, albo nie mogą być w ogóle osiągnięte innymi metodami. ALD jako metoda osadzania cienkich warstw oferuje również:
- precyzyjną kontrolę grubości warstwy w skali nanometrycznej,
- warstwy pinhole-free np. dla pasywacji powierzchni,
- powlekanie podłoży o dużej powierzchni i skomplikowanych kształtach, jak również porowatych materiałów sypkich, czy proszków,
- wysoką powtarzalność.
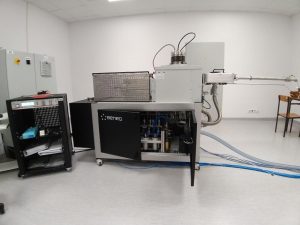 Reaktor ALD produkcji Beneq, Espoo, Finlandia, model TFS 200-302 z 2021 roku.
Reaktor ALD produkcji Beneq, Espoo, Finlandia, model TFS 200-302 z 2021 roku.
Reaktor może pracować w trybie prowadzenia procesów:
- termicznych: w zakresie temperatur osadzania 10-280°C, z użyciem wody, ozonu lub tlenu, jako czynników utleniających.
- Temperatury ogrzewania prekursorów:
ciekłych – 0-20°C, 10-350°C,
stałych – 10-500°C. - Wymiary części sadzeniowej komory reaktora:
maksymalna średnica – 20 cm,
maksymalna grubość – od 1 cm do 10 cm.
- Temperatury ogrzewania prekursorów:
- wspomaganych plazmą: w zakresie temperatur osadzania 10-200°C, z użyciem tlenu, jako czynnika utleniającego.
- Temperatury ogrzewania prekursorów:
ciekłych – 0-20°C, 10-350°C,
stałych – 10-500°C. - Wymiary części sadzeniowej komory reaktora:
maksymalna średnica – 20 cm,
maksymalna grubość – od 1 cm do 2 cm.
- Temperatury ogrzewania prekursorów:
Właściwości mechaniczne wytwarzanych warstw mogą być badane z użyciem nanointendera, który jest zlokalizowany w Pracowni Mikroskopii Korelacyjnej.
Twardościomierz (nanoindenter) GES5E produkcji Alemnis AG, Szwajcaria z 2022 roku.
Urządzeniem można wykonywać pomiary twardości z obciążeniem w zakresie 0,5–0,004 N wgłębnikiem Berkovicha lub pomiary zarysowań wgłębnikiem Rockwella.
Urządzenie jest głowicą z systemem piezoelektrycznym, które może pracować w komorze próżniowej mikroskopu SEM lub w atmosferze otaczającej w mikroskopie świetlnym. Zestaw posiada możliwość korelacji wyników pomiarów z obiema technikami obrazowania SEM i LM.
Laboratorium wykonuje prace badawcze i usługi zlecone naukowo-badawcze dla jednostek naukowych oraz podmiotów gospodarczych.
Podstawą wyceny wykonywanych analiz jest dzień roboczy pracy reaktora ALD wraz z obsługą, który wynosi 4 200,00 zł netto/dzień roboczy. Ostateczne koszty wykonania usługi będą uzależnione od indywidualnej umowy z usługobiorcą.
Dodatkowym kosztem jest wykonanie pomiarów nanointendacyjnych, które są wycenione na:
- 292,00 zł netto/godzinę pracy w mikroskopie optycznym,
- 414,00 zł netto/godzinę pracy w skaningowym mikroskopie elektronowym.
W celu uzyskania szczegółowych informacji prosimy o kontakt:
dr hab. Piotr Piszczek, prof. UMK
tel.: +48 607 883 357
e-mail: piszczek@umk.pldr hab. Aleksandra Radtke, prof. UMK
tel.: +48 600 321 294
e-mail: aradtke@umk.plWydział Chemii
Uniwersytet Mikołaja Kopernika w Toruniu
u. Gagarina 7
87-100 Toruń


 ul. Gagarina 7, 87-100 Toruń
ul. Gagarina 7, 87-100 Toruń